|
|
市場調査レポート
商品コード
1331432
先進パッケージングの進化に不可欠なハイブリッドボンディング技術Hybrid Bonding Technology Portrays Essential Role as Advanced Packaging Continues to Evolve |
||||||
| 先進パッケージングの進化に不可欠なハイブリッドボンディング技術 |
|
出版日: 2023年08月17日
発行: TrendForce
ページ情報: 英文 11 Pages
納期: 即日から翌営業日
|
- 全表示
- 概要
- 目次
2.5Dおよび3Dの先進パッケージング技術と組み合わせたチップレットの利用は、ムーアの法則に従ってチップの計算性能を継続的に向上させるために、ハイエンドチップの必然的な開発動向の1つになるに違いないです。とはいえ、ハイエンドチップの性能を十分に発揮させる妨げとなる既存のマイクロバンプボンディング技術は、ハイブリッドボンディングに取って代わられる必要があります。本レポートでは、チップレット設計と先進パッケージング技術の開発動向を分析し、今後のハイエンドチップ開発におけるハイブリッドボンディング技術の必要性と開発モメンタムを探ります。
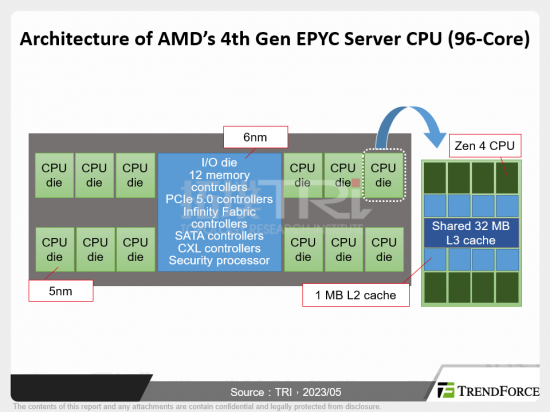
TRIは半導体、テレコミュニケーション、IoT、自動車システム、人工知能、新興技術のアプリケーション、主要地域市場(米国、欧州、日本、韓国、中国、台湾など)の最新動向など、幅広いテーマに取り組んできた調査会社です。1996年に設立され、2015年にTrendForceの一部となりました。TRIのサービスは、新しく形成される技術産業や地域開発に関するトレンドを的確に把握することから、様々なタイプの組織から高い評価を得ています。
当レポートではハイブリッドボンディングの開発動向についてTRIの見解を提供します。
目次
第1章 ムーアの法則の続き- チップレット設計と先進パッケージング技術が組み合わされて主流になる
第2章 ハイブリッドボンディングによる重要な成果
第3章 ハイエンド CISおよびCPU製品向けに継続的に拡大が予想されるハイブリッドボンディングの容量:チップ積層に関するバンプボンディングの利点
第4章 TRIの見解
The utilization of chiplets paired with 2.5D and 3D advanced packaging technology is bound to become one of the inevitable development trends of high-end chips in order to allow a continuous elevation of computing performance for chips according to the Moore's Law. With that being said, the existing micro-bump bonding technology that could impede high-end chips from fully exerting their performance would have to be replaced by hybrid bonding. This report analyzes development trends of chiplet design and advanced packaging technology on the one hand, and probes into the necessity and development momentum of the hybrid bonding technology on future development of high-end chips on the other hand.




