
|
市場調査レポート
商品コード
1939018
先進パッケージング:市場シェア分析、業界動向と統計、成長予測(2026年~2031年)Advanced Packaging - Market Share Analysis, Industry Trends & Statistics, Growth Forecasts (2026 - 2031) |
||||||
カスタマイズ可能
適宜更新あり
|
|||||||
| 先進パッケージング:市場シェア分析、業界動向と統計、成長予測(2026年~2031年) |
|
出版日: 2026年02月09日
発行: Mordor Intelligence
ページ情報: 英文 126 Pages
納期: 2~3営業日
|
概要
先進パッケージング市場は、2025年の516億2,000万米ドルから2026年には575億7,000万米ドルへ成長し、2026年から2031年にかけてCAGR 11.53%で推移し、2031年までに993億9,000万米ドルに達すると予測されています。
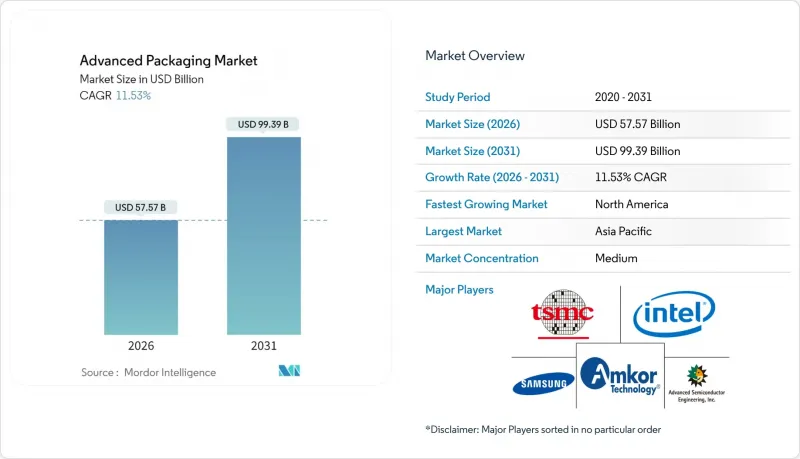
従来パッケージの熱的・相互接続限界を超える人工知能(AI)プロセッサにおいて、ヘテロジニアス統合が不可欠となったため、需要は当初の予測を上回りました。これに対応し、統合デバイスメーカー(IDM)や外部委託半導体組立・試験(OSAT)プロバイダーは設備投資を加速させ、各国政府は組立能力の国内化に向けて大規模な優遇措置を講じました。先進パッケージング市場は、ガラスコア基板の研究開発、パネルレベル加工のパイロット導入、ハイパースケールデータセンターにおける光学部品共封装技術の急速な普及からも恩恵を受けました。しかしながら、BT樹脂基板の不足やエンジニアリング人材の不足がタイムリーな生産能力拡大を妨げたため、供給は逼迫した状態が続きました。ファウンドリがAIサプライチェーンのエンドツーエンド管理を確保するためパッケージングを内製化したことで競争が激化し、従来のOSAT業者の利益率を圧迫するとともに、戦略的な専門化を促しました。
世界の先進パッケージング市場の動向と洞察
AIおよびHPC向けヘテロジニアス統合の需要増加
AIワークロードには、従来のパッケージング技術では達成不可能な演算密度とメモリ帯域幅が求められます。TSMCのCoWoSプラットフォームは、単一構造内にチップレットと高帯域メモリを統合し、主要AIアクセラレータベンダー間で急速に採用が進んでいます。サムスンのSAINT技術は、次世代HBM4スタックに対応するハイブリッドボンディングを用いて同様の目標を達成し、自社内での先進パッケージング技術の戦略的価値を浮き彫りにしました。サーマルインターフェース材料、特殊基板、アクティブインターポーザーの導入により、パッケージコストは半導体製造材料費全体の15~20%に上昇しました(主流CPUでは5~8%)。その結果、AIシステムの市場投入時期を決定する上で、先進パッケージングの生産能力は最先端ファブと同等の重要性を帯びました。したがって、先進パッケージング市場は、前工程プロセスの移行に遅れを取るのではなく、並行して成長を遂げています。
民生機器の小型化がWLP採用を促進
スマートフォン、ウェアラブル機器、ヒアラブル機器は、常に薄型化と高機能密度を求め続けています。ファンアウト・ウェーハレベルパッケージング(FOWLP)は、0.5mm未満の超薄型パッケージ内に複数のダイを組み込むことを可能にし、熱性能を損なうことなくフラッグシップモバイルプロセッサをサポートします。ファンインWLPからFOWLPへの移行により、アンダーフィル、ワイヤボンディング、積層基板が不要となったため、システム全体のコストを最大25%削減できました。小型化の潮流は、寸法が生命に関わる埋め込み型医療電子機器分野にも波及しました。リードレスペースメーカーはWLP技術により、厳しい信頼性目標を達成しつつデバイスサイズを93%削減することに成功しました。結果として、民生用と医療用の需要が持続的な基盤を形成し、先進パッケージング市場をPCエンド市場の周期的な変動から保護する役割を果たしました。
高い資本集約性が市場参入を制約
2.5Dおよび3Dプロセス用ツールのコストは、1チャンバーあたり1,000万~1,500万米ドルに達し、従来ラインの典型的な300万米ドルを大幅に上回ります。TSMCは2025年に420億米ドルの設備投資を予算化し、その相当部分が先進パッケージングの拡張に充てられました。そのため、中小OSAT企業は急速に短縮する製品ライフサイクル全体で投資を償却するのに苦慮し、ニッチ分野への特化や防衛的合併を促されました。この高いハードルレートにより、トップティア企業と地域追随企業間の技術格差が拡大し、2024年から2026年にかけて先進パッケージング市場における新規設備投資が抑制される見込みです。
セグメント分析
2025年にはフリップチップパッケージが48.30%の収益シェアで首位を維持し、大量生産される民生用・産業用アプリケーションが基盤となりました。しかしながら、AIアクセラレータがフリップチップの限界を超えるロジックとメモリの近接性を要求したため、2.5D/3D構成が最も急速な成長を遂げ、13.05%のCAGR見通しを達成しました。2.5D/3Dソリューションの先進パッケージング市場規模は、2031年までに389億米ドルに達し、プラットフォーム総収益の39.15%を占めると予測されています。
サムスンのSAINTプラットフォームは10μm未満のハイブリッドボンディングを実現し、ワイヤボンディング方式と比較して信号遅延を30%低減、熱的余裕を40%拡大しました。TSMCのCoWoSは2025年に3ラインを追加増産し、12ヶ月分の受注残を解消しました。埋め込みダイとファンアウトWLPは補完的な選択肢として進展しました:埋め込みパッケージはスペース制約のある自動車分野に適し、ファンアウトWLPは5G基地局やミリ波レーダー設計を獲得しました。これらの動向が相まって、2.5D/3Dパッケージングは次世代デバイスロードマップの中心に位置づけられ、先進パッケージング市場における主要な価値ドライバーとしての役割を確固たるものにしました。
民生用電子機器は2025年出荷量の39.20%を占めましたが、その成長率は一桁台で頭打ちとなりました。これに対し、自動車およびEV向け需要はCAGR12.32%で拡大し、2031年までに先進パッケージング市場におけるシェアを18.6%まで押し上げると予測されています。自動車電子機器向け先進パッケージング市場規模は、予測期間終了までに185億米ドルを超えると推定されます。
EV用トラクションインバーター、車載充電器、ドメインコントローラーでは、現在、自動車グレードのファンアウト型、両面冷却パワーモジュール、オーバーモールド方式のシステムインパッケージ(SiP)アセンブリが採用されています。データセンターインフラも高成長分野の一つです。AIサーバーでは1,000W/cm2に達する電力密度を実現する先進パッケージングが利用され、革新的なサーマルリッドやアンダーフィル材料の開発が求められています。一方、医療分野では生体適合性コーティングや気密エンクロージャーが求められており、これらの特性は高価格帯の平均販売価格と安定した交換需要をもたらします。これらのセグメント動向が相まって、収益源の多様化が進み、先進パッケージング市場におけるスマートフォン更新サイクルへの依存度が低下しました。
先進パッケージング市場は、パッケージングプラットフォーム(フリップチップ、埋め込みダイ、ファンインWLPなど)、エンドユーザー産業(民生用電子機器、自動車・EV、データセンター・HPCなど)、デバイスアーキテクチャ(2D IC、2. 5Dインターポーザー、3D IC)、インターコネクト技術(はんだバンプ、銅ピラー、ハイブリッドボンディング)、地域(北米、南米、欧州、アジア太平洋、中東・アフリカ)によって区分されます。
地域別分析
アジア太平洋地域は2025年の収益の74.10%を占めました。これは、台湾、韓国、中国本土にフロントエンドファブおよび基板サプライヤーの大半が立地しているためです。TSMCは1,650億米ドルの米国投資を発表しましたが、これは台湾拠点の置き換えではなく、多様化戦略を反映したものであり、中期的にはアジアが主導権を維持することを保証するものです。中国の国内OSAT(受託組立・テスト)企業は二桁の売上増を達成し、自動車向けパッケージング分野へも進出しましたが、極端紫外線(EUV)装置に対する厳しい規制により、最先端のウェーハ製造プロセスへの参入は制限されています。
北米はCHIPS法の優遇措置により、CAGR12.38%で最速成長地域として台頭しました。アムコール社の20億米ドル規模のアリゾナ工場は、2027年のフル稼働時にはバンプ、ウェハーレベル、パネルレベルのラインを統合し、米国システムインテグレーター近郊初の大規模アウトソーシング拠点を形成します。インテル、アップル、エヌビディアは、地政学的な供給中断リスクを軽減するため、この生産能力の一部を事前予約し、従来は東アジアのOSAT(受託組立・テスト)企業に流れていた相当量の生産を転換させました。その結果、先進パッケージング市場には、大量のAI製品をサポート可能な信頼性の高い北米供給拠点が加わりました。
欧州は量産主導ではなく専門分野の追求を選択しました。オンセミのチェコ工場は自動車用パワー向け炭化ケイ素デバイスに特化し、現地OEMの電動化目標に沿った生産体制を構築。ドイツのフラウンホーファー研究所はパネルレベル技術の調査を主導しましたが、メーカー各社は新規メガサイトへの投資には慎重な姿勢を維持しました。一方、シンガポールはハブ機能を強化。マイクロンのHBM工場とKLAのプロセス制御拡張により、単一管轄区域内でAIメモリと計測技術を支える垂直統合型エコシステムが構築されました。インドは資本コスト50%分担制度を導入し、中期的成長が見込まれる先進パッケージングのパイロット提案を誘致しましたが、人材確保が課題となっています。
これらの動きが相まって、システムOEMメーカーの地理的リスクは分散され、先進パッケージング市場は再均衡化されました。それでもなお、アジア太平洋地域は2031年においても60%以上のシェアを維持すると予測されています。既存のインフラ、供給クラスター、規模の経済が、新規参入地域を依然として上回っているためです。
その他の特典:
- エクセル形式の市場予測(ME)シート
- アナリストによる3ヶ月間のサポート
よくあるご質問
目次
第1章 イントロダクション
- 調査の前提条件と市場の定義
- 調査範囲
第2章 調査手法
第3章 エグゼクティブサマリー
第4章 市場情勢
- 市場概要
- マクロ経済要因の影響
- 市場促進要因
- AIおよびHPC向けヘテロジニアス統合の需要増加
- 民生機器の小型化がWLP採用を促進
- 政府による半導体補助金(例:CHIPS法、EUチップス法)
- EV用パワーエレクトロニクスの信頼性要件(先進パッケージング)
- 新興のガラスコア基板がパネルレベルパッケージングを実現
- ハイパースケールデータセンターにおける共封装光学部品の需要
- 市場抑制要因
- 先進パッケージングラインの高い資本集約度
- 業界再編による外部委託マージンの縮小
- BT樹脂基板の生産能力不足
- 高度な組立技術者の不足
- バリューチェーン分析
- 規制情勢
- テクノロジーの展望
- ポーターのファイブフォース分析
- 新規参入業者の脅威
- 買い手の交渉力
- 供給企業の交渉力
- 代替品の脅威
- 競合の激しさ
- 投資分析
第5章 市場規模と成長予測
- パッケージングプラットフォーム別
- フリップチップ
- 組み込みダイ
- ファンインWLP
- ファンアウトWLP
- 2.5D/3D
- エンドユーザー業界別
- 民生用電子機器
- 自動車および電気自動車
- データセンターおよびHPC
- 産業用およびIoT
- 医療/医療技術
- デバイスアーキテクチャ別
- 2D IC
- 2.5Dインターポーザー
- 3D IC(TSV/ハイブリッドボンド)
- インターコネクト技術別
- はんだバンプ
- コッパーピラー
- ハイブリッドボンド
- 地域別
- 北米
- 米国
- カナダ
- メキシコ
- 南米
- ブラジル
- アルゼンチン
- その他南米
- 欧州
- ドイツ
- フランス
- 英国
- イタリア
- オランダ
- ロシア
- その他欧州地域
- アジア太平洋地域
- 中国
- 台湾
- 韓国
- 日本
- シンガポール
- マレーシア
- インド
- その他アジア太平洋地域
- 中東・アフリカ
- 中東
- イスラエル
- アラブ首長国連邦
- サウジアラビア
- トルコ
- その他中東
- アフリカ
- 南アフリカ
- ナイジェリア
- その他アフリカ
- 中東
- 北米
第6章 競合情勢
- 市場集中度
- 戦略的動向
- 市場シェア分析
- 企業プロファイル
- Amkor Technology, Inc.
- Taiwan Semiconductor Manufacturing Company Limited
- Advanced Semiconductor Engineering, Inc.
- JCET Group Co., Ltd.
- Samsung Electronics Co., Ltd.
- Intel Corporation
- Chipbond Technology Corporation
- ChipMOS Technologies Inc.
- Powertech Technology Inc.
- TongFu Microelectronics Co., Ltd.
- Nepes Corporation
- STATS ChipPAC Pte. Ltd.
- Siliconware Precision Industries Co., Ltd.
- UTAC Holdings Ltd.
- Walton Advanced Engineering, Inc.
- Xintec Inc.
- Tianshui Huatian Technology Co., Ltd.
- King Yuan Electronics Co., Ltd.
- Signetics Corporation
- GlobalFoundries Inc.
- Semiconductor Manufacturing International Corporation
- SFA Semicon Co., Ltd.
- Nantong Fujitsu Microelectronics Co., Ltd.
- Hana Micron Inc.
- Unisem(M)Berhad

